Como reduzir as perdas, melhorar a eficiência e ampliar a faixa de temperatura em aplicações de alta potência
Contributed By DigiKey's North American Editors
2023-09-08
Os projetistas de aplicações com uso intensivo de potência exigem conversores de energia menores, mais leves e mais eficientes, capazes de operar em tensões e temperaturas mais altas. Isso é particularmente verdadeiro em aplicações como veículos elétricos (EVs), em que essas melhorias se traduzem em carregamento mais rápido e maior autonomia. Para obter essas melhorias, os projetistas estão usando conversores de energia baseados em tecnologias de ampla banda proibida (WBG), como o carbeto de silício (SiC).
Em comparação com o silício (Si), esses dispositivos operam em tensões mais altas e pesam menos, mas têm recursos semelhantes para lidar com a potência. Eles também operam em temperaturas mais altas, com necessidade reduzida do sistema de resfriamento. Os dispositivos em SiC podem operar em uma frequência de chaveamento mais alta, permitindo o uso de componentes passivos menores que reduzem o tamanho e o peso do conversor. Ainda assim, o SiC está em constante desenvolvimento, com os esforços mais recentes resultando em uma menor resistência “on” ou de saturação, reduzindo ainda mais as perdas de potência.
Este artigo discute brevemente as vantagens do SiC em relação ao Si, usando EVs como contexto. Em seguida, ele discute os desenvolvimentos do SiC antes de apresentar os MOSFETs de SiC de 4ª geração da ROHM Semiconductor e ilustrar como eles ajudam os projetistas a reduzir as perdas de potência, o custo e a pegada (área ocupada)
Por que usar o SiC?
Os EVs precisam de maior capacidade da bateria para aumentar a autonomia. Em conjunto com essa tendência, as tensões das baterias estão sendo aumentadas para 800 volts a fim de reduzir o tempo de carregamento. Como resultado, os projetistas de EVs precisam de dispositivos que possam suportar essas tensões mais altas e, ao mesmo tempo, reduzir as perdas elétricas e o peso. Os MOSFETs de SiC de 4a geração da ROHM Semiconductor proporcionam perdas menores por meio de maior tolerância à tensão, menores perdas de condução e chaveamento e tamanhos menores.
O SiC, um semicondutor WBG, oferece eficiência excepcional em aplicações de chaveamento de potência de alta tensão em relação à tecnologia MOSFET de Si. Uma comparação das propriedades físicas do SiC e do Si mostra a fonte dessa melhoria com base em cinco propriedades físicas: campo elétrico de ruptura, banda proibida, condutividade térmica e ponto de fusão (Figura 1).
 Figura 1: São mostradas as vantagens dos MOSFETs de SiC em relação aos de Si com base em cinco propriedades físicas. (Fonte da imagem: ROHM Semiconductors)
Figura 1: São mostradas as vantagens dos MOSFETs de SiC em relação aos de Si com base em cinco propriedades físicas. (Fonte da imagem: ROHM Semiconductors)
A intensidade do campo elétrico de ruptura do SiC é dez vezes maior do que a do Si, o que possibilita projetar dispositivos com tensões de ruptura mais altas e, ao mesmo tempo, reduzir a espessura do dispositivo. A banda proibida mais larga do SiC permite ao dispositivo operar a temperaturas muito mais altas. A condutividade térmica mais alta reduz o esforço necessário para resfriar o dispositivo, enquanto o ponto de fusão mais alto aumenta a faixa de temperatura operacional. Por fim, a maior velocidade de deriva de elétrons saturados do SiC resulta em frequências de chaveamento possivelmente mais altas e menores perdas de chaveamento. Essas frequências de chaveamento mais altas exigem filtros menores e outros componentes passivos, reduzindo ainda mais o tamanho e o peso.
Desenvolvimento de MOSFETs
Os MOSFETs de SiC originais usavam uma estrutura planar em que a porta e o canal do dispositivo ficavam na superfície do semicondutor. Os dispositivos planares são limitados em sua densidade de componentes, pois há um limite de quanto os designs podem ser reduzidos em tamanho na tentativa de melhorar o rendimento do dispositivo. O uso de MOSFETs de trincheira simples e dupla oferece a capacidade de atingir densidades mais altas de dispositivo (Figura 2).
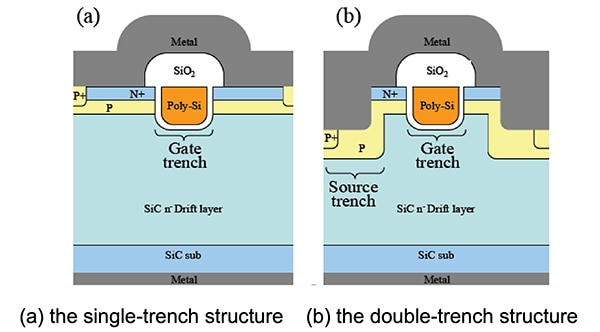 Figura 2: Os MOSFETs de trincheira atingem densidades mais altas de dispositivo ao organizar os elementos do dispositivo verticalmente. (Fonte da imagem: ROHM Semicondutor)
Figura 2: Os MOSFETs de trincheira atingem densidades mais altas de dispositivo ao organizar os elementos do dispositivo verticalmente. (Fonte da imagem: ROHM Semicondutor)
Como outros MOSFETs, uma célula MOSFET de trincheira contém o dreno, a porta e a fonte, mas é disposta verticalmente. O canal se forma verticalmente, paralelo à trincheira da porta, por meio do efeito de campo. A direção do fluxo de corrente é vertical, da fonte para o dreno. Em comparação com um dispositivo plano, que é espalhado horizontalmente e ocupa uma boa parte da área de superfície, essa estrutura é muito compacta.
A estrutura de trincheira única usa uma trincheira de uma porta. O dispositivo de trincheira dupla tem uma trincheira de porta e uma trincheira de fonte. A ROHM Semiconductor mudou para a estrutura de trincheira dupla em seus MOSFETs de SiC de 3a geração. O projeto de quarta geração avançou o projeto de trincheira dupla diminuindo o tamanho da célula, reduzindo ainda mais a resistência de estado saturado e a capacitância parasita, levando a perdas de potência muito menores e oferecendo a opção de usar dispositivos SiC menores para projetos de sistemas mais econômicos.
A redução da resistência de estado saturado de um MOSFET pode comprometer sua capacidade de lidar com curtos-circuitos. No entanto, o MOSFET de SiC de quarta geração atinge uma resistência de saturação sem sacrificar o tempo para suportar o curto-circuito, o que dá a esses dispositivos uma vantagem significativa quando se trata de obter alta eficiência e robustez em curto-circuito.
Compreensão das perdas
As perdas em um conversor de modo chaveado vêm de várias fontes; aquelas associadas aos dispositivos ativos incluem perdas de condução, do chaveamento e do diodo incorporado (Figura 3).
 Figura 3: É mostrado um esquema de um conversor CC/CC do tipo buck legendado para mostrar as formas de onda do chaveamento e as formas de onda das perdas associadas. (Fonte da imagem: ROHM Semicondutor)
Figura 3: É mostrado um esquema de um conversor CC/CC do tipo buck legendado para mostrar as formas de onda do chaveamento e as formas de onda das perdas associadas. (Fonte da imagem: ROHM Semicondutor)
O conversor buck usa um design totem pole com um comutador MOSFET no lado de alta (SH) e um no lado de baixa (SL). Os comutadores ou chaves são acionados fora de fase para haver apenas uma condução por vez. As formas de onda do acionamento da porta (VGSH e VGSL) mostram as etapas de amplitude devido aos intervalos de carregamento associados às capacitâncias parasitas do dispositivo. São mostradas as formas de onda da tensão dreno-fonte (VDSH, VDSL) e da corrente de dreno (IDH, IDL) para ambos os dispositivos. Quando o dispositivo está ligado, o VDS é baixo. Quando o dispositivo está desligado, o VDS é alto. Durante o tempo em que o SH está ligado, a corrente de dreno aumenta linearmente enquanto carrega o campo magnético do indutor. Durante esse tempo, a corrente através da resistência do canal desenvolve uma tensão através do canal, resultando em perdas de condução (PCOND) que são proporcionais ao quadrado da corrente e à resistência de saturação do canal. Durante os intervalos em que o dispositivo muda de estado, a tensão e a corrente são diferentes de zero, e a potência é dissipada no dispositivo proporcionalmente à tensão, à corrente, ao tempo de transição do chaveamento e à frequência de chaveamento. Essas são as perdas de chaveamento.
Uma situação semelhante ocorre quando o SL está ligado. Aqui, a corrente diminui linearmente à medida que a energia armazenada no indutor fornece a corrente de dreno no dispositivo inferior. Novamente, a resistência do canal dissipa potência como uma perda de condução. Observe que o VDSL no dispositivo inferior está próximo de zero, antes que a corrente se torne diferente de zero, portanto, não há perdas de chaveamento associadas a essa parte do ciclo.
A perda de recuperação (PQrr) é causada pela recuperação do diodo incorporado aos dispositivos; para simplificar, ela é mostrada apenas para o lado de alta.
Pbody é a condução do diodo incorporado aos dispositivos. Essa perda é gerada pela corrente conduzida pelo diodo incorporado ao dispositivo do lado de baixa.
A perda total de potência é a soma de todos esses componentes para ambos os transistores.
Desempenho aprimorado dos MOSFETs de SiC de 4a geração
Uma comparação do desempenho do IGBT de Si, bem como dos MOSFETs de SiC de 3a e 4a geração, foi realizada usando um inversor de ponte completa de 5 quilowatts (kW) (Figura 4). Nesse circuito de ponte completa, os dispositivos de chaveamento são conectados em paralelo para aumentar a capacidade de corrente. A ponte completa usa um total de oito dispositivos. Os oito dispositivos são mostrados montados no dissipador de calor da imagem à esquerda. A eficiência do circuito foi avaliada usando o IGBT original e os MOSFETs de 3a e 4a geração. O inversor opera em uma frequência de chaveamento de 40 quilohertz (kHz) com os MOSFETs de SiC e a 20 kHz com o IGBT.
 Figura 4: São mostrados um inversor sem ventoinha de 5 kW e seu esquema. Originalmente projetado com IGBTs de silício funcionando a 20 kHz, esse circuito funcionou com MOSFETs de SiC de 3a e 4a geração a 40 kHz. O desempenho de todos os três tipos de semicondutores foi comparado. (Fonte da imagem: ROHM Semicondutor)
Figura 4: São mostrados um inversor sem ventoinha de 5 kW e seu esquema. Originalmente projetado com IGBTs de silício funcionando a 20 kHz, esse circuito funcionou com MOSFETs de SiC de 3a e 4a geração a 40 kHz. O desempenho de todos os três tipos de semicondutores foi comparado. (Fonte da imagem: ROHM Semicondutor)
O dispositivo de 3a geração era um dispositivo ROHM Semiconductor SCT3030AL dimensionado em 650 volts com uma resistência de canal (RDS(ON)) de 30 miliohms (mΩ). O MOSFET de 4a geração era um ROHM Semiconductor SCT4026DEC11. A tensão nominal no dispositivo de 4a geração foi aumentada para 750 volts. Seu RDS(ON) é de 26 mΩ, uma redução de 13% que diminuiu ligeiramente as perdas de condução.
Uma comparação das perdas de ambos os MOSFETs de SiC com as do IGBT original mostra a melhoria na eficiência (Figura 5).
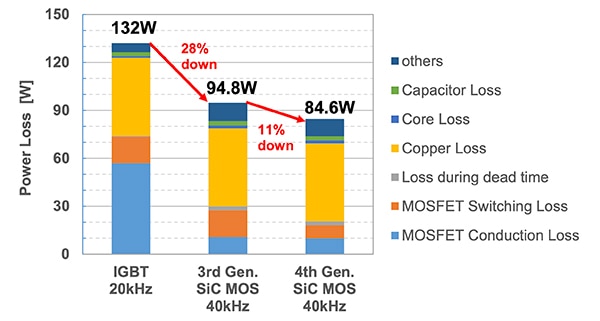 Figura 5: Os MOSFETs de SiC de 4a geração reduziram significativamente as perdas em comparação com o IGBT de Si original e o dispositivo de 3a geração. (Fonte da imagem: ROHM Semicondutor)
Figura 5: Os MOSFETs de SiC de 4a geração reduziram significativamente as perdas em comparação com o IGBT de Si original e o dispositivo de 3a geração. (Fonte da imagem: ROHM Semicondutor)
O dispositivo de 4a geração reduziu as perdas de condução (azul) de 10,7 para 9,82 watts em comparação com o dispositivo de 3a geração. Uma redução mais significativa foi obtida com as perdas de chaveamento (laranja), uma diminuição de 16,6 para 8,22 watts.
Outras melhorias nos dispositivos de 4a geração incluem recursos aprimorados de acionamento de porta. Os MOSFETs de SiC de quarta geração suportam a condução com 15 volts; os dispositivos de terceira geração exigem 18 volts. Isso significa que os circuitos projetados com dispositivos de Si podem usar MOSFETs de 4a geração como substitutos imediatos. Além disso, a tensão de acionamento recomendada durante o desligamento é de 0 volts para os MOSFETs de SiC de 4ª geração. Antes dos produtos de 4a geração, a tensão porta-fonte precisava de uma polarização negativa durante o desligamento para evitar a autoativação. Entretanto, nos dispositivos de quarta geração, a tensão de limiar (Vth) foi projetada para ser alta a fim de suprimir a autoativação, eliminando a necessidade de aplicação de polarização negativa.
Soluções da 4a geração
As soluções MOSFET de SiC da 4a geração da ROHM Semiconductor se dividem em dois grupos com base no invólucro do dispositivo. O SCT4026DEC11, que foi discutido, é um MOSFET de SiC de 750 volts, 56 amperes (A) (+25°C)/29 A (+100°C), 26 mΩ em um invólucro TO-247N de três terminais. Um exemplo do invólucro alternativo de quatro terminais é o SCT4013DRC15, um dispositivo de 750 volts, 105 A (+25°C)/74 A (+100°C), 13 mΩ em um invólucro TO-247-4L de quatro terminais.
O invólucro de quatro terminais acrescenta um condutor extra que melhora a velocidade de chaveamento do MOSFET. O invólucro convencional TO-247N de três pinos não isola o acionamento de porta da indutância parasita do terminal da fonte devido à alta corrente de dreno. A tensão da porta é aplicada entre os pinos da porta e da fonte. A tensão efetiva da porta no chip é reduzida devido à queda de tensão através da indutância parasita (VL) do terminal da fonte, fazendo com que a velocidade de chaveamento seja reduzida (Figura 6).
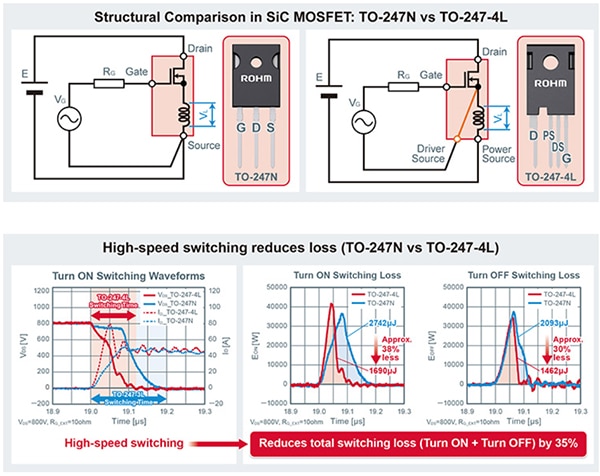 Figura 6: O quarto pino no TO-247-4L isola o acionamento de porta dos pinos da fonte de alimentação usando um pino de conexão adicional em uma conexão Kelvin. (Fonte da imagem: ROHM Semicondutor)
Figura 6: O quarto pino no TO-247-4L isola o acionamento de porta dos pinos da fonte de alimentação usando um pino de conexão adicional em uma conexão Kelvin. (Fonte da imagem: ROHM Semicondutor)
O invólucro TO-247-4L de quatro pinos divide o acionamento de porta e os pinos da fonte de alimentação, conectando o acionamento de porta diretamente à fonte interna. Isso minimiza os efeitos da indutância parasita do pino da fonte. A conexão direta do acionamento de porta com a fonte interna permite maximizar a velocidade de chaveamento dos MOSFETs de SiC, reduzindo a perda total de chaveamento (ligar e desligar) em até 35% em comparação com os invólucros TO-247N convencionais de três pinos.
A segunda especificação diferenciadora para os MOSFETs de SiC de 4a geração é a tensão nominal. Os dispositivos estão disponíveis com tensões nominais de 750 volts ou 1200 volts. Os dois dispositivos discutidos até agora têm tensão nominal de 750 volts. Para aplicações de tensão mais alta, o SCT4062KEC11 é um MOSFET em SiC de canal N de 1200 volts, 62 mΩ, 26 A (+25°C)/18 A (+100°C) em um invólucro TO-247N de três terminais, enquanto o SCT4036KRC15 é um MOSFET de canal N de 1200 volts, 36 mΩ, 43 A (+25°C)/30 A (+100°C) em um invólucro TO-247-4L de quatro terminais. No total, há atualmente dez MOSFETs de SiC de 4a geração disponíveis, com correntes nominais de 26 A a 105 A em +25°C. Eles têm valores de RDS(ON) que variam de 13 a 62 mΩ.
Aplicações em EV
As especificações do MOSFET de SiC de 4a geração são bem adequadas às aplicações em EV. Os EVs de bateria (BEVs) com tensões de 400 ou 800 volts são um exemplo (Figura 7).
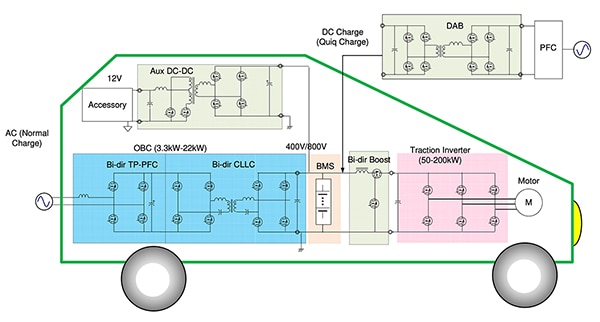 Figura 7: Aplicações típicas do MOSFET de SiC de 4a geração em um BEV e acessórios externos associados. (Fonte da imagem: ROHM Semicondutor)
Figura 7: Aplicações típicas do MOSFET de SiC de 4a geração em um BEV e acessórios externos associados. (Fonte da imagem: ROHM Semicondutor)
A Figura 7 mostra um diagrama de blocos de um BEV com uma tensão de bateria de 400 ou 800 volts, com suporte para carregamento bidirecional e rápido. O carregador na placa (OBC) inclui circuitos de correção do fator de potência (PFCs) do tipo totem-pole e um conversor ressonante CLLC (capacitor, indutor, indutor, capacitor) de ponte completa bidirecional. O carregador CC externo de carga "Quiq" fornece carga direta à bateria. A bateria aciona o inversor de tração, que converte a CC em CA trifásica para acionar o motor. Todos esses circuitos empregam MOSFETs em várias configurações de circuito para lidar com os níveis de potência necessários. Os MOSFETs em SiC de 4a geração são importantes porque reduzem o tamanho físico do circuito e aumentam a tensão nominal, reduzindo as perdas e os custos.
Conclusão
Para os projetistas de aplicações de alta tensão e alta potência, incluindo veículos elétricos, data centers e estações-base, os MOSFETs de SiC de 4a geração são dispositivos essenciais de chaveamento de potência. Conforme mostrado, eles usam uma estrutura exclusiva para melhorar muito a eficiência da conversão de energia, reduzindo as perdas e, ao mesmo tempo, a pegada e o custo.
Leitura recomendada:

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.







